针对特定市场的封装解决方案
MicroLeadframe® (MLF®/QFN) 封装技术是当今发展最快的 IC 封装解决方案。从细分市场的角度来看,MLF® 封装解决方案在 2022 年将成为超过 1,110 亿件的市场,其中涉及 5 个独特市场:汽车、消费、工业、计算/网络以及通信。这些市场的封装解决方案要求各不相同,但是,MLF® 封装给每个市场带来的基本价值是一致的:(1) 灵活的外观规格;(2) 适应性强的互连技术;(3) 电气和热力性能;以及 (4) 经济高效的解决方案。

MLF® 封装灵活的外观规格使该技术能够服务所有市场,满足尺寸、环境和应用方面的独特要求。例如,塑造空腔的能力已证实使 MLF® 成为 MEMS 和传感器市场的多功能解决方案,而改变封装厚度的能力使这项技术能够满足便携式手持设备市场严格的尺寸要求。
从传统的焊线设计到高凸块数量铜柱倒装芯片设计,多互连解决方案已被证明切实可行。使用不同直径的金、铜和银线可以满足对性能和成本的要求,同时实现各种晶圆技术(如硅、氮化镓和 SOS)所需的广泛的互联解决方案,技术节点范围为 120 纳米到 7 纳米。

外露晶粒贴装焊盘(顶部和/或底部)赋予这种封装技术独特的能力,使其可以满足高性能网络设备和功率设备的热需求。对大直径焊线和功率 FET 铜片的集成能力,使 MLF® 封装解决方案能够延伸至高功率应用,并满足从汽车到消费者游戏产品等不同市场的严格要求。
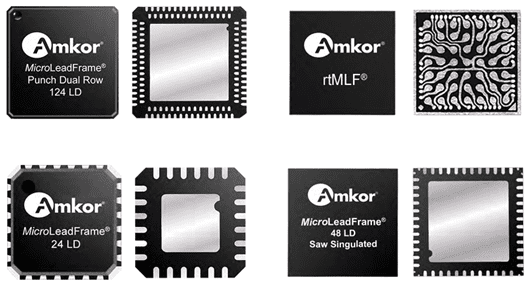
这项技术采用的新材料组合专门针对零分层和 QEC-Q-100 与 AEC-Q-006 在汽车可靠性方面的严格要求,使技术应用场景扩展到此前由引线式封装解决方案主导的应用,如 LQFP、MQFP、TQFP 和 SOIC。粗化的引线框架表面处理、改进的环氧树脂晶片附着材料、用于汽车应用的薄膜晶片附着,以及可提高铜线性能的改进型模塑化合物,这些工艺扩展了 MLF® 封装技术的价值。
Amkor 的 MLF® 技术是一种市场适应型、创新型、成本敏感型技术。MLF® 结合灵活的外观规格和适应性互连能力,能够满足不同市场需求和多种应用要求。Amkor 致力与您密切合作,制定符合需求的最佳解决方案。
关于作者
Marc Mangrum 于 2010 年加入 Amkor,现任 MLF 产品高级总监® 。在加入 Amkor 之前,Marc 在 Motorola 和 Freescale 工作了 30 多年。他的能力包括新封装技术开发、数字/模拟 IC 的先进 ATE 技术解决方案以及降低成本的 IC 封装设计和组装工艺。Marc 发表了 30 多篇论文,并获得了 33 项专利。Marc 毕业于德克萨斯大学奥斯汀分校,拥有数学、电气工程和工商管理方面的核心能力。


