독자적 시장을 위한 패키징 솔루션
마이크로 리드프레임® (MLF®/QFN) 패키징 기술은 오늘날 가장 빠르게 성장 중인 IC 패키징 솔루션입니다. 시장 세분화 관점에서 볼 때 MLF® 패키징 솔루션은 2022년에 독자적인 5개 시장에서 1110억 유닛 이상의 시장을 점유하고 있습니다. 그 시장들은 바로 자동차, 소비재, 산업, 컴퓨팅/네트워킹, 통신입니다. 각기 다른 패키지 솔루션을 요구하는 이들 시장에서 MLF® 패키징이 공통으로 제공하는 근본적인 가치는 (1) 유연한 폼팩터, (2) 변통성 있는 인터커넥트 기술, (3) 전기 및 열 성능, (4) 비용 효율적인 솔루션입니다.

폼팩터가 유연한 MLF® 패키징은 시장 특성에 맞는 기술을 제공하고, 각 시장 고유의 규모, 환경, 적용 요건에 부응할 수 있습니다. 예를 들면 캐비티를 형성할 수 있어, MEMS 및 센서 시장에서 다양한 역할을 하며 패키지 두께 조정이 가능하여 휴대용 제품 시장의 까다로운 사이즈 요건도 충족시킵니다.
여러 가지 인터커넥트 솔루션으로 우수성을 인정받고 있으며, 기본 와이어 본드 설계부터 범프 수가 많은 구리 기둥 플립칩 설계까지 다양한 솔루션을 제공합니다. 다양한 직경의 금, 구리, 은 와이어를 사용하여 성능과 비용 요건을 충족시키는 동시에 120 nm ~ 7 nm 공정 노드의 실리콘, 질화갈륨, SOS 등 여러 가지 웨이퍼 기술에 필요한 폭넓은 인터커넥트 솔루션을 구현할 수 있습니다.

이 패키징 기술은 다이 어태치 패드를 노출시킴으로써(상부, 하부 또는 양쪽 모두) 고성능 네트워크 장치와 전력 장치의 열 관련 필요를 충족시키는 독자적인 기능을 구현합니다. 직경이 큰 본드 와이어와 전력 FET용 구리 클립을 통합하는 기술을 갖춘 MLF® 패키징 솔루션은 고성능 애플리케이션으로 확장될 수 있으며, 자동차와 소비자 게임 제품 분야 등과 같은 몹시 까다로운 시장 요건을 충족시킬 수 있습니다.
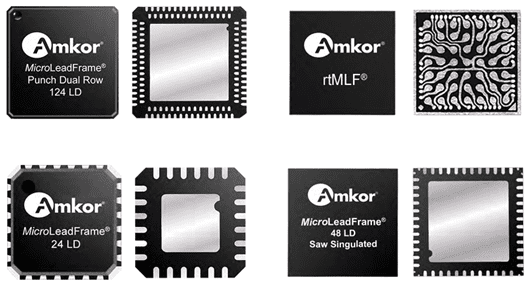
새로운 재료 세트는 특히 무박리와 QEC-Q-100 및 AEC-Q-006와 같은 까다로운 차량용 신뢰성 요구 사항 충족을 목표로 합니다. LQFP, MQFP, TQFP, SOIC와 같이 납땜 패키지 솔루션이 주를 이룬 애플리케이션에도 이 새로운 기술을 활용하며 사용 범위가 확장되고 있습니다. 거친 리드프레임 마감, 개선된 에폭시 다이 어태치 소재, 자동차 애플리케이션을 위한 필름 다이 어태치, 구리 와이어 성능 향상을 위해 개선한 몰딩 컴파운드가 MLF® 패키징 기술의 가치를 더욱 높입니다.
앰코의 MLF® 기술은 시장 적응력과 혁신성을 갖추었으며 비용에 민감한 기술입니다. 이러한 MLF®는 유연한 폼팩터와 인터커넥트 기술을 함께 활용해서, 다양한 시장의 필요와 애플리케이션 요건을 충족하는 독자적인 입지를 구축했습니다. 앰코가 귀사의 필요에 맞는 최적의 솔루션을 함께 찾아드리겠습니다.
작성자 정보
Marc Mangrum은 2010년에 앰코에 합류했으며 현재 MLF® 제품 부문 수석입니다. 앰코에 합류하기 전까지 30년 이상 Motorola 와 Freescale에서 근무했습니다. 새로운 패키징 기술, 디지털/아날로그 IC용 고급 ATE 기술 솔루션, 비용 절감형 IC 패키지 설계 및 조립 프로세스를 개발하는 그는 지금까지 논문을 30편 이상 발표하고 특허를 33건 등록했습니다. 미국 오스틴에 있는 텍사스 대학교에서 수학, 전기 공학, 경영학을 집중적으로 수학했습니다.


