ユニークマーケット向けのパッケージングソリューション
マイクロリードフレーム® (MLF®/QFN)パッケージングテクノロジーは、現在、拡大の速度が最も速いパッケージングソリューションです。市場セグメントの観点からは、MLF®パッケージングソリューションは、 自動車、民生、産業、コンピューティング/ネットワーキング 、通信の5つのユニークな市場において、2022年には1,110億個を超えると予想されています。これらの市場で求められるパッケージソリューションは様々ですが、MLF®パッケージングが各市場にもたらす基本的な価値は一貫して同じです。:(1)柔軟なフォームファクター、(2)適応性のある相互接続技術、(3) 電気的および熱的 性能、(4)コスト効率の高いソリューション

MLF®パッケージングの柔軟なフォームファクターは、独自の寸法、環境、アプリケーションの要件を満たし、あらゆる市場に対応する テクノロジー を可能にします。例えば、キャビティ形成が可能なMLF®は、 MEMSやセンサー 市場において汎用的なソリューションであることが証明されており、パッケージの厚さを変えることができるため、携帯型ハンドヘルド市場の厳しいサイズ要件に対応できるようになりました。
従来のワイヤーボンド設計からバンプ数の多い Cuピラー フリップチップ設計まで、複数の配線ソリューションが実証されており、利用可能です。さまざまな直径を持つAu、Cu、Agワイヤーを使用することで、性能面とコスト面に対する要求を満たすとともに、120nmから7nmまでの技術ノードを持つシリコン、GaN、SOSなどの様々なウェハ技術に必要な幅広い インターコネクトに対するソリューション が可能になります。

チップアタッチパッド(上面、底面、もしくは両方)が露出しているため、高性能ネットワーク機器やパワー機器の熱ニーズに対応できるユニークなパッケージング技術となっています。 パワー FET向けに大口径のボンドワイヤーとCuクリップを組み込むことができるため、MLF® パッケージングソリューションは高出力アプリケーションに拡大し、自動車から民生用ゲーム製品まで、非常に厳しい市場要件に対応することが可能になりました。
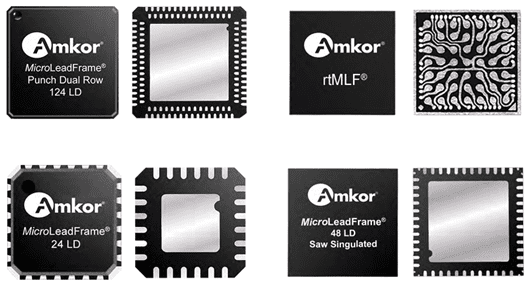
新しい素材は、特に層間剝離を完全になくすことを目標としており、QEC-Q-100やAEC-Q-006による自動車向けの信頼性に関する厳しい要求により、これまで LQFP、 MQFP、 TQFP、 SOICなどのリード型パッケージソリューションが主流だった用途に、このテクノロジーの使用事例が拡大されています。リードフレームの粗面化、エポキシ系チップアタッチ材料の改良、車載用フィルムチップアタッチ、銅線性能を向上させるモールドコンパウンドの改良により、MLF®パッケージ技術の価値を高めることができます。
AmkorのMLF®テクノロジーは、市場への適応力が高く、革新的で、コストに敏感なテクノロジーです。MLF®は、柔軟なフォームファクターと適応性の高い相互接続機能を組み合わせることで、様々な市場ニーズやアプリケーション要件に対応できるユニークな製品となっています。御社のニーズに適したベストソリューションを検討する際は、ぜひAmkorにご相談ください。
著者
Marc Mangrumは2010年にAmkorに入社し、現在はMLF® の製品部門でシニア・ディレクターを務めています。Amkorに入社する前のMarcは、MotorolaとFreescaleで30年以上勤務していました。彼には、新規のパッケージング技術や、デジタルおよびアナログIC向けの先進的なATE技術ソリューションの開発、さらにコストを抑えた ICパッケージの設計や組立プロセスなどのスキルがあります。これまでに30を超える数の論文を発表しおり、また、33種類の特許を取得しています。テキサス大学オースティン校を卒業し、数学、電気工学、経営管理に関する専門知識を有しています。


