2.5D TSV 技术的力量
Amkor Technology 扩大 2.5D TSV 产能:
为 AI 和 HPC 铺平道路
Amkor Technology, a leader in semiconductor packaging and test services, has just unveiled some exciting news that promises to shake up the tech industry. Amkor is expanding its capacity for 2.5D through silicon via (TSV) technology, underscoring its dedication to innovation and leadership in advanced packaging and test.
Amkor’s 2.5D TSV technology is revolutionizing the high-performance computing (HPC) sector and artificial intelligence (AI) applications. But what makes 2.5D TSV so groundbreaking? This technology allows for integrating different components on a TSV-bearing silicon substrate using redistribution layers (RDL) wafer-level processing. Amkor’s packaging solutions achieve unmatched performance by interconnecting logic chips and high-bandwidth memory in close proximity.
This integration enhances bandwidth, reduces power consumption, and improves electrical performance, making it perfect for data-intensive tasks like AI algorithms. As AI shapes our world, the need for efficient processing power grows exponentially. Amkor’s 2.5D TSV technology accelerates AI workloads by seamlessly combining memory and logic, resulting in faster computations and smarter decision-making.
下方所示的 2.5D TSV 产品示例展现了 Amkor 的生产能力。
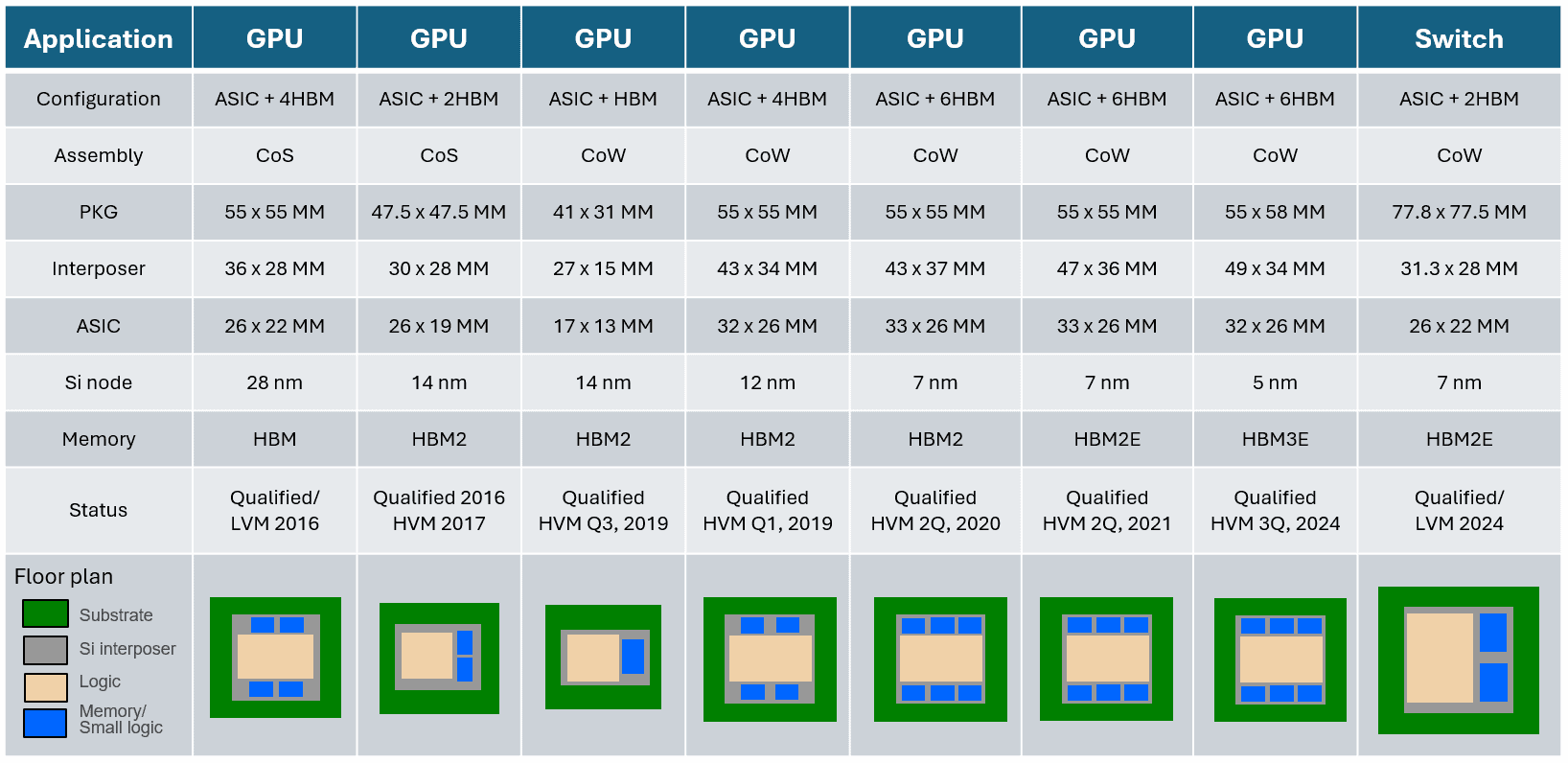
自 2016 年以来,Amkor 一直在进行基板上芯片 (CoS) 的大批量生产 (HVM),并且自 2019 年以来,也在大批量生产晶圆上芯片 (CoW)。
Amkor 追求卓越的承诺不仅限于技术,更在于满足行业不断发展的需求。为此,Amkor 正在将其 2.5D TSV 生产能力提高两倍。此次产能扩容计划于 2024 年第四季度完成,这将使 Amkor 成为半导体领域的关键参与者。Amkor 最近出货了第二百万件 2.5D TSV 产品,这在业内具有重要的里程碑意义。这些创新产品对于 AI、HPC 等领域的尖端应用至关重要。从自动驾驶到医疗诊断,AI 都依赖于强大的计算能力,而 Amkor 的 2.5D TSV 技术使 AI 系统能够高效地处理海量数据。此外,高性能计算要求速度、精度和可扩展性,Amkor 的先进技术可确保 HPC 集群以最佳状态运行,从而推动科学突破和复杂模拟的发展。
Amkor 的 2.5D TSV 技术在推进 AI 能力方面发挥了关键作用。展望未来,我们的产能扩容将巩固我们在尖端解决方案领域的领先地位。Amkor 的使命不仅仅是开发芯片,更是塑造未来。Amkor 始终专注于质量、可靠性和性能,正如 TSV 技术,一步一个脚印,推动技术和创新向前发展。


