适用于 5G 和无线连接的移动解决方案
如今,完全集成的 RFFE 模块可在单个封装中整合功率放大器 (PA)、低噪声放大器 (LNA)、开关、收发器、滤波器和离散天线。集成采用系统级封装 (SiP) 技术,包括双面封装、先进晶圆级再布线层 (RDL)、被动元件集成和精密的 RF 屏蔽技术等,以提供最先进的 5G 封装解决方案。
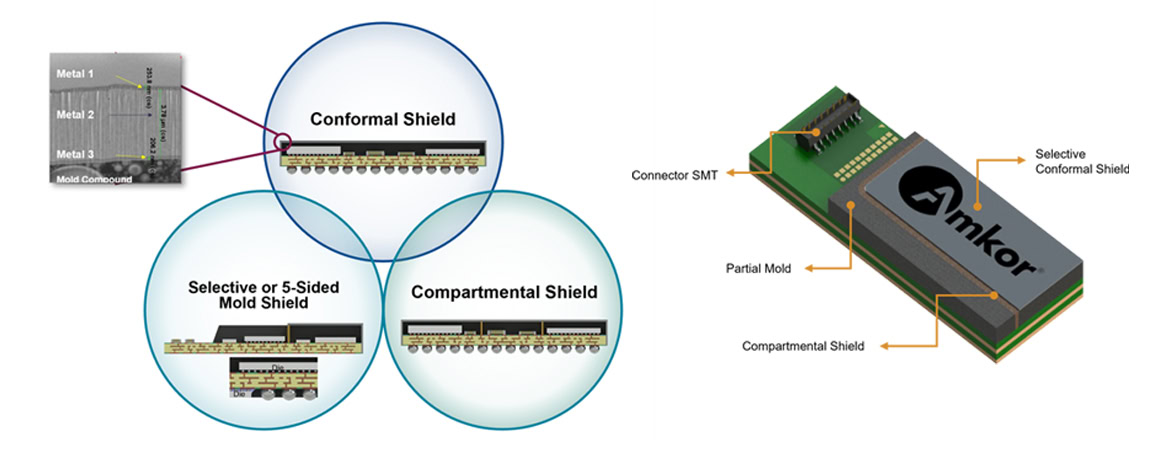
封装内天线 (AiP) 和封装上天线 (AoP) 技术将天线集成到设备封装中,而不再作为无线设备内的单独元件。AiP/AoP 简化了毫米波应用的难度,有助加快系统设计。如今,AiP/AoP 技术可通过标准或定制 SiP 模块实现。

AiP/AoP

应用
- 汽车
- IoT 智能设备
- 移动
RF 前端 (RFFE)
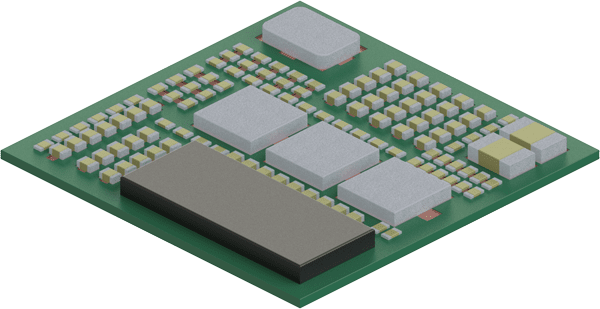
应用
- 汽车
- IoT 智能设备
- 移动
有问题?
点击下方的 “获取信息“ 按钮,
联系 Amkor 专业人士。