适用于电源和 RF 应用的超紧凑、高性能封装
Amkor 的倒装芯片 MicroLeadFrame® (fcMLF®/fcQFN/SON/DFN) 封装以紧凑、高性价比的外观规格提供最先进的性能。这种近似 CSP 的塑料封装解决方案采用铜引线框架基板和先进的互连技术设计,支持 Amkor 的所有凸块选项,包括铜柱和无铅焊料。结果呢?与相同芯片尺寸的传统引线键合 MicroLeadFrame 封装相比,封装尺寸可缩小 70% ,从而实现更时尚的设计和更强大的功能。
fcMLF 封装专为提高可靠性和效率而设计,采用外围引脚,可与印刷电路板 (PWB) 进行可靠电气连接。该封装还采用了 Amkor 的 ExposedPad 技术,具有卓越的热性能和电气性能。通过将晶片附着焊盘暴露在底面上,在直接焊接到 PWB 时可有效散热,从而确保最佳的功率承载和器件的长期可靠性。
更小巧,更智能,更酷炫Amkor 的倒装芯片 MicroLeadFrame 是要求以最小占用空间实现高性能的下一代应用的理想解决方案。
应用

Amkor 的 fcMLF 封装为当今的高性能应用提供了无与伦比的多功能性和可靠性。fcMLF 是电源管理集成电路 (PMIC)、DC/DC 转换器和 RF 开关的理想之选,它将先进的设计与久经考验的卓越制造技术相结合,可满足紧凑型高能效系统的需求。
为确保合规和封装简便,fcMLF 支持可润湿侧翼设计(包括凹槽和阶梯切割配置),从而在电路板安装后无需 X 射线即可进行快速、准确的目视检查。这一功能对于汽车级设备至关重要,因为汽车级设备对质量保证和可靠性要求极高。
fcMLF 节省空间,具有强大的热性能和可用于汽车的检测能力,是追求创新而不妥协的工程师的明智之选。
Amkor 的 fcMLF 技术通过几项关键创新提供了先进的性能。铜柱凸块可为引线框架设计提供精细的 160 μm 凸块线距,支持更高密度的互连。模塑底部填充 (MUF) 无需采用成本高昂的传统底部填充工艺,而对晶片进行助焊剂浸渍则无需对引线框架进行预镀锡处理,从而简化了封装过程。Saw MLF® 工艺流程确保了精度和可靠性。
这种封装具有出色的热管理和高频信号性能,经证明工作频率 ≥20 GHz,能够处理超过 4 W 的功率,是电源管理集成电路 (PMIC) 应用的理想解决方案。
工艺亮点:
- 封装尺寸缩小 70%
- 输入/输出计数范围为:1-76
- 晶片尺寸:0.5 x 0.5 mm 至 9 x 9 mm
- 封装尺寸:1 x 1 mm 至 10 x 10 mm
- 封装厚度: 0.35 mm 至最大高度 1.45 mm
- 凸块类型:
- 铜柱
- 无铅焊料
- 凸块线距:
- 内引线线距:最小 160 μm
- 凸块间隙(同网):50 μm
- 一站式解决方案—设计、凸块、晶圆探针、封装和最终测试
该封装旨在满足汽车行业的严格要求,包括:
- 细引线间距配置为 0.50 mm 和 0.65 mm
- 沿引线侧区域增加了焊料填充高度,以提高连接完整性
- 焊球脱离阻力 (BLR) 性能等于或超过传统设计
- 消除 SMD 后 X 射线检查要求
Amkor 公司已对这一工艺进行了鉴定,并将其投入大批量生产 (HVM)。
 |
 |
Amkor 器件采用优化的封装设计,使用合格的高可靠性半导体材料进行组装,以确保性能稳定和长期可靠性。所有封装完全符合 JEDEC 标准,并能满足 AEC-Q100 1 级和 0 级要求,支持在苛刻的汽车环境中运行。
- 湿度敏感性特性:JEDEC 级别 1*、85°C/85% 相对湿度、168 小时
- uHAST:130°C/85% 相对湿度,96 小时
- 温度循环: -65°C/+150°C,500 次循环
- 高温储存:150°C,1000 个小时
*取决于材料清单 (BOM)、封装尺寸和设计
 |
 |
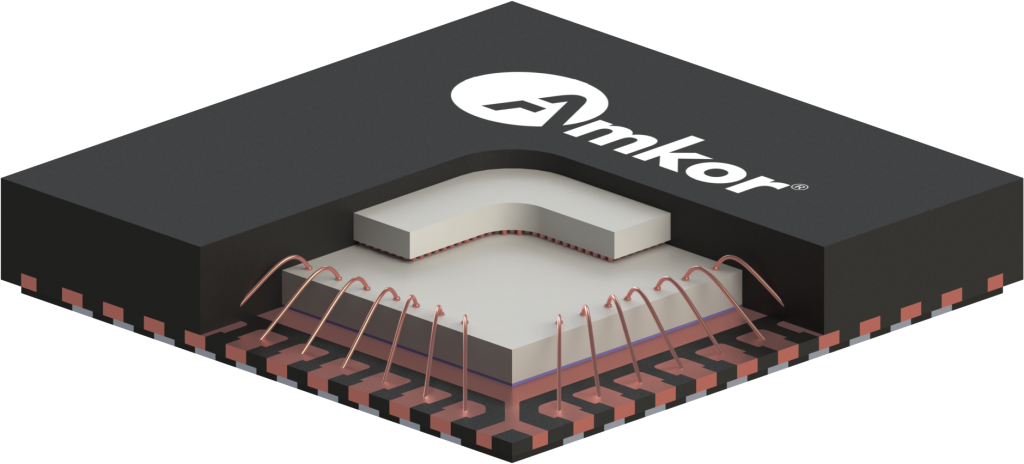 |
 |
有问题?
点击下方的 “获取信息“ 按钮,
联系 Amkor 专业人士。