Packages for improved warpage control and integrity
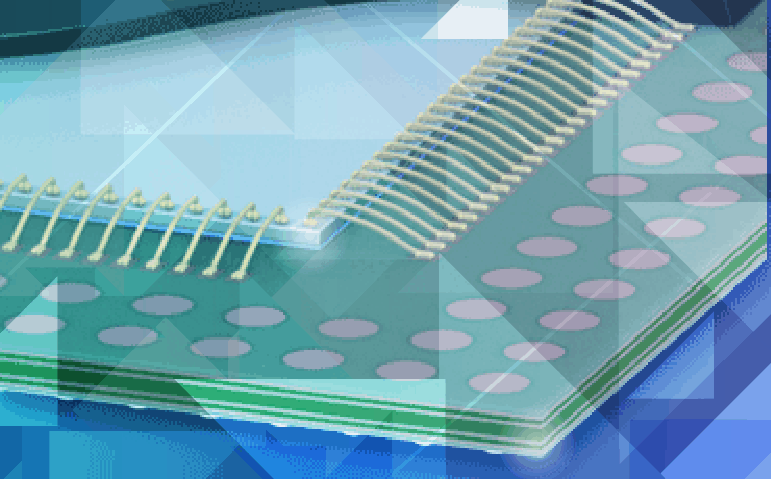
携帯電話、デジタルカメラ、ゲーム機器およびその他のモバイルアプリケーションなどのポータブル電子機器は、パッケージ・オン・パッケージ(PoP)によるスタックパッケージおよび小フットプリントの組合わせがそのメリットを発揮できる製品です。
Amkorは、PoPの実装面積と高さの低減を組合わせた高密度スタックインターフェイスなどを要求される次世代PoPにおいてリーディングカンパニーであり続けるため、技術力と量産能力を継続的に向上して参ります。
Package Stackable Very Thin Fine Pitch BGA(PSvfBGA):2004年に量産開始された、シングルチップおよびワイヤボンドまたはハイブリッド(FC+ワイヤボンド)を使用したスタックチップに対応し、テストやSMTハンドリング時のパッケージ反りを改善したパッケージです。
Package Stackable Flip Chip CSP(PSfcCSP):FcCSPの組立フローとPSvfBGAのパッケージスタッキング技術を統合し、チップ裏面露出型パッケージを可能にしました。PSfcCSPは、センターモールドを行うPSvfBGAで課題とされていた0.5 mmのファインピッチのスタック接続を可能にする薄型のチップ露出構造を備えています。
Through Mold Via Package-on-Package(TMV®PoP):モールドキャップにインターコネクトビアを備えた次世代PoPソリューションです。TMV技術は下部パッケージのパッケージサイズに対するチップ占有比率を拡大し、また薄型基板の使用を可能にします。TMVは、シングルチップ、スタックチップ、FCデザインに適用可能です。TMVは、0.4 mmピッチ低電力DDR2メモリインターフェイスに対する理想的なソリューションであり、0.3 mmピッチまたはそれ以下のはんだボールピッチを実現し、スタック接続に必要な面積縮小を可能にします。
ご質問やお問合せはこちらまで
以下の「リクエスト」をクリックしてご連絡ください